Optické vlastnosti
Pokud budeme uvažovat o lokální analýze optických vlastností, musíme si zejména
připomenout fundamentální limit, kterým je vlnová délka světla, jímž chceme vzorek analyzovat.
Nejvyšší možné optické rozlišení, kterého můžeme dosáhnout, je difrakcí omezeno přibližně na polovinu
vlnové délky a konvenčními přistupy není možné tuto bariéru překonat. Využití světla v nanometrologii
pomocí standardních přístrojů (reflektometr, elipsometr) je tímto omezeno na sběr dat s rozlišením v řádu stovek nanometrů.
I tak je ovšem možné konvenčními metodami získat zajímavé informace v mikro- a částečně
nanoměřítku. Pomocí metod rastrovací nebo mapovací reflektometrie či elipsometrie můžeme měřit
např. rozložení indexu lomu na optoelektronických prvcích nebo planárních světlovodech. Vzhledem k tomu,
že metody analýzy takových dat jsou známé a propracovávané již více než sto let, nejistota optických měření
pomocí takových zařízení může být v desetinách či setinách procenta.
Pokud se nicméně chceme dostat na prostorové rozlišení v úrovni nanometrů, musíme zcela
zásadně změnit strategii měření. Jednou cestou je využití zdroje nebo detektoru světla v těsné blízkosti k povrchu,
jako je tomu u rastrovací optické mikroskopie v blízkém poli
(SNOM - scanning near field optical microscopy). Sondou rastrovacího mikroskopu je v tomto případě optické
vlákno s aperturou 50-100 nm, kterou vychází nebo kterou je sbíráno světlo.
Ačkoliv je metoda SNOM v každém případě revoluční co se týče rozlišení, a po svém znovuobjevení
v osmdesátých letech minulého století vyvolala velký ohlas např. mezi biology, interpretace dat
je podstatně složitější, než tomu bylo u výše zmíněných konvenčních metod. Samotná interakce mezi hrotem a povrchem
je poměrně složitý jev, k jehož pochopení je nutné provádět numerické výpočty; kromě toho je geometrie hrotu v principu
neznámá a v průběhu měření se může měnit.
|
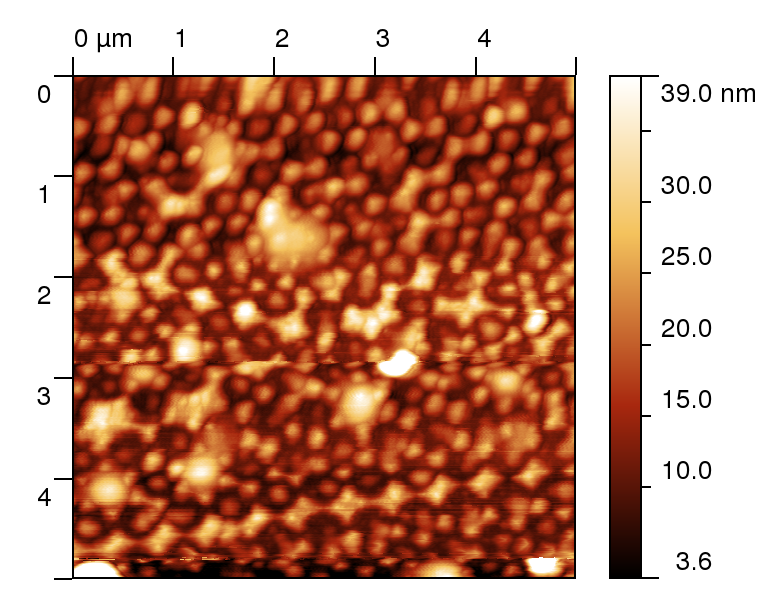 |
| SNOM snímek hliníkových ostrůvků na skle |
Určitým řešením je využití bezaperturní mikroskopie, ve které je optické vlákno nahrazeno
rozptylem na kovovém hrotu AFM. Ani zde však není interpretace dat jednoduchá, navíc odstup signálu od šumu může být
ještě podstatně horší než u aperturních měření.
Pokud tedy chceme provádět optická měření s rozlišením vyšším, než jaké dovoluje vlnová délka,
musíme se v současnosti spokojit jen s kvalitativní analýzou. Naší snahou je za pomoci numerických výpočtů metodou
FDTD najít podmínky, za kterých by bylo možné získávat z výše uvedených metod alespoň nějaká kvantitativní data.
|

