Teplota a tepelná vodivost
Tepelné ztráty jsou jedním z hlavních limitujících faktorů při miniaturizaci
mikroelektroniky. Při průchodu elektrického proudu vysoce integrovanými
mikroelektronickými obvody se v podstatě všechen výkon proměňuje na teplo,
které je nutné odvádět, přičemž menší a více integrovaná součástka
poskytuje méně možností, jak odvod tohoto tepla realizovat. Zahřívání přitom
znamená nejen spotřebu elektrické energie, ale také potencionálně větší množství chyb
při zpracování signálů, čemuž je nutné součástku přizpůsobit. Je proto důležité
generování tepla, a tedy také spotřebu, minimalizovat.
Dokud byly velikosti mikroelektronických prvků v řádu mikrometrů, bylo možné
sledovat rozložení lokální teploty například pomocí infračervené kamery. Rozlišení
takových konvenčních metod ale nemůže být v principu lepší než v řádu mikrometrů.
Řešením je využít metody rastrovací sondové mikroskopie, konkrétně rastrovací termální
mikroskopii (SThM - scanning thermal microscopy). Využitím speciálního hrotu
jsme schopni měřit současně tvar povrchu a jeho teplotu s prostorovým rozlišením
v řádu desítek nanometrů a tepelným rozlišením v desetinách stupně Celsia.
Na snímku je zobrazen povrch zahřátého mikrostrukturovaného čidla pro detekci vodíku.
Zjevný rozdíl teplot mezi platinovou a keramickou částí čidla je dán různou emisivitou
obou povrchů - keramický povrch více vyzařuje a tím pádem je i více ochlazován.
|
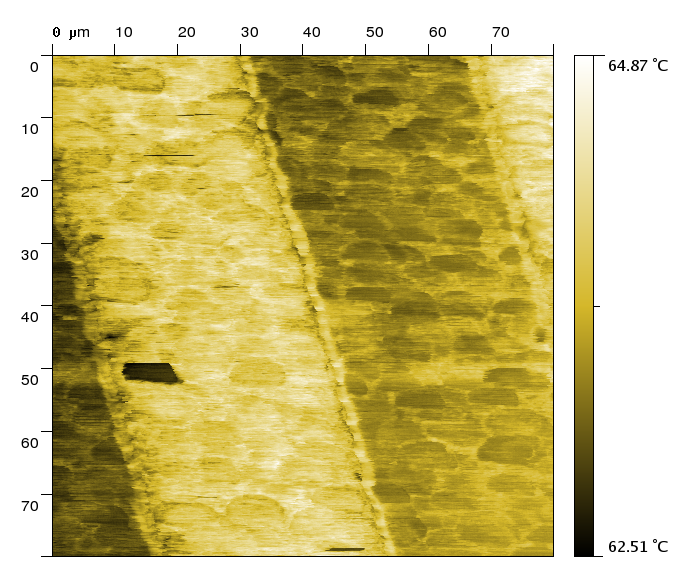 |
| Mapování teploty na povrchu vodíkového čidla |
Další fyzikální vlastností, kterou můžeme pomocí rastrovacího termálního mikroskopu sledovat,
je tepelná vodivost. Tu je důležité znát nejen při výrobě mikroelektronických prvků,
ale i při návrhu různých nanokompozitních materiálů, ať už jsou vyráběny se snahou o
velkou tepelnou vodivost, nebo naopak o dokonalé izolační vlastnosti.
I zde je možné říct, že žádná konvenční metoda není schopna poskytnout tak velké
prostorové rozlišení. Na druhou stranu jsou metody SThM zatím poměrně daleko
od skutečně robustní kvantitativní analýzy (kalibrace vyžaduje použití speciálních vzorků,
při měření pozorujeme mnoho systematických chyb), takže pro vzorky, které nejsou malé
nebo mikrostrukturované je stále výhodnější použít konvenční metody.
|

